在製作晶片的过程中,有一道关键工序常默默发挥着不可替代的作用──CMP 化学机械研磨。它不像曝光、蚀刻那样容易被人记住,但却是每颗先进晶片能顺利诞生的重要推手。
从崎岖到平坦:CMP 为什么重要?
晶片的製作就像盖摩天大楼,一层层往上堆叠。问题是,每盖完一层,地面──也就是晶圆表面──会变得凹凸不平。如果不先刨平,下一层就会失去平衡。这时,CMP 就像一位专业的「地坪师傅」,负责把晶圆打磨得平滑,让后续製程精準落位。
CMP 是什么?
CMP,全名是「化学机械研磨」(Chemical Mechanical Polishing),顾名思义,它同时利用化学反应与机械抛光来修整晶圆表面。
首先,晶圆会被轻放在机台的承载板(pad)上并固定。机台準备好柔韧的抛光垫与特製的研磨液,像舞台布景与道具就位。当旋转开始,晶圆正面朝下贴向抛光垫,两者同步旋转。研磨液缓缓滴落,里面的磨料颗粒与化学药剂开始发挥作用──化学反应软化表层材料,机械抛光轻轻刮除凸起,凹凸逐渐消失。当这段「打磨舞」结束,晶圆会进入清洗程序,洗去所有磨粒与残留物,表面乾净如镜,準备迎接下一道工序。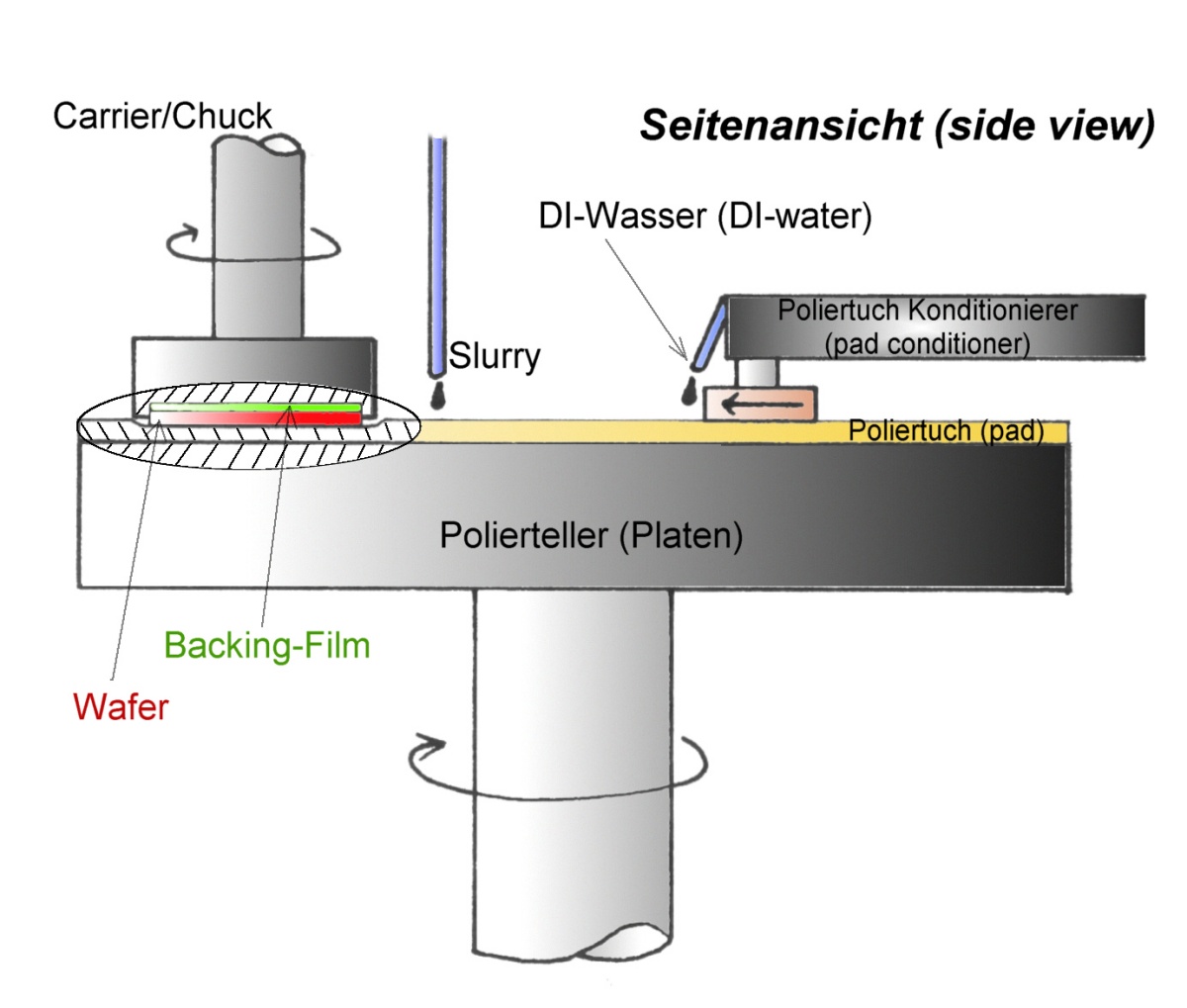
(Source:wisem, Public domain, via Wikimedia Commons)
CMP 用在什么地方?
CMP 是晶片製造过程中多次出现的角色:
- 绝缘层平坦化:在浅沟槽隔离(STI)结构中,填入氧化层后透过 CMP 磨除多余部分,让表面与周围平齐。
- 金属层平坦化:在导线间的接触孔或通孔填入金属(如钨、铜)后,CMP 将表面多余金属磨掉,只保留孔内部分。
- 多层製程过渡:每铺上一层介电层或金属层,都需要 CMP 让表面恢复平整,确保后续曝光与蚀刻精準进行。
研磨液是什么?
在 CMP 製程中,研磨液(slurry)是关键耗材之一,品质优良的研磨液才能让晶圆表面研磨得光滑剔透。根据晶圆材质与期望的平坦化效果,会选用不同类型的研磨液。
台积电、联电及力积电等晶圆厂在製程中所使用的,多属于高阶 CMP 研磨液,其供应几乎完全依赖国际大厂。主要合作对象包括美国的 Cabot Microelectronics、DuPont,以及日本的 Fujimi 与 Showa Denko 等企业。
研磨液的配方不仅包含化学试剂,pH 调节剂与最重要的研磨颗粒(slurry abrasive)同样影响结果。选择研磨液并非只看单一因子,而是一门讲究配比与工艺的学问。
研磨颗粒依材质大致可分为三类:二氧化硅(Silica-based slurry)、氧化铝(Alumina-based slurry)、氧化铕(Ceria-based slurry)
每种颗粒的形状与硬度各异,有的表面较不规则,有的则较平滑;不同化合物对材料的去除选择性也不同,会影响研磨精度与表面品质。
至于研磨液中的化学成分(slurry chemical),其 pH 值、氧化剂与腐蚀剂配方会直接影响最终研磨结果。有些酸硷化学品能软化材料表层结构,协助提升去除效率;而稳定剂与分散剂则能防止研磨颗粒在长时间储存或使用中发生结块与沉澱,确保研磨液性能稳定、效果一致。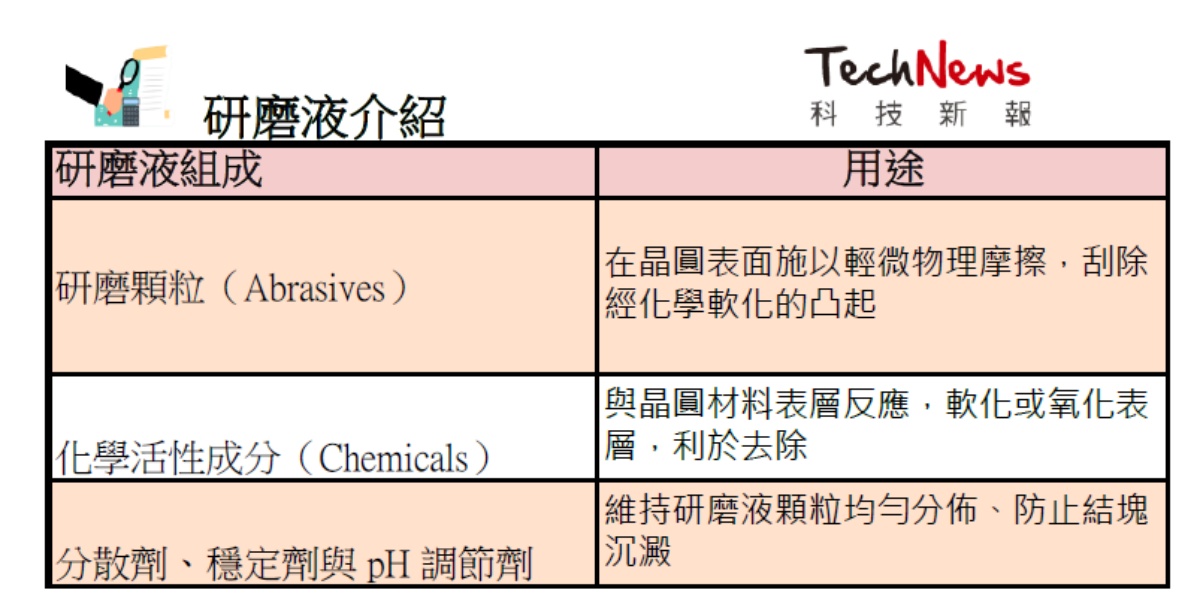
CMP 虽然精密,但挑战不少:磨太多会刮伤线路,磨太少则平坦度不足。此外,随着製程进入奈米等级,材料愈来愈脆弱,像低介电常数材料(low-k)硬度远低于传统氧化层,容易在研磨时受损。
因此,业界正持续开发更柔和的研磨液、新型抛光垫,以及 AI 实时监控系统,让 CMP 过程更精準、稳定,适应未来更先进的製程需求。
CMP,晶片背后的隐形英雄
下次打开手机、启动 AI 应用时,可以想像晶片内的电晶体,正排列在一片由 CMP 精心打磨出的平坦舞台上。虽然 CMP 很少出现在新闻头条,但它就像建筑中的地基工程,是晶片世界中不可或缺的隐形英雄。
(首图来源:Fujimi)

 微信扫一扫打赏
微信扫一扫打赏
 支付宝扫一扫打赏
支付宝扫一扫打赏

